IC基板に関する知識を広げる
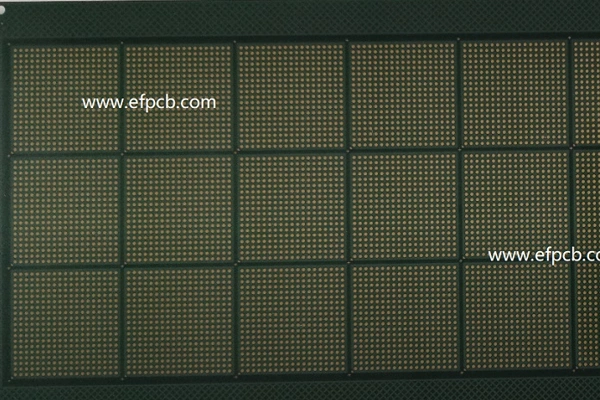
キーワード: ICキャリア基板
協調回路基板、またはICキャリア基板は、近年、注目を集めるようになりました。これは、ボールグリッドアレイやチップスケールパッケージなどの集積回路タイプの発展に起因しています。ICキャリア基板が表すもの、例えばICパッケージは、新しいパッケージキャリアを必要とします。電子機器のエンジニアや設計者として、ICパッケージ基板の重要性を理解するだけではもはや十分ではありません。ICキャリア基板の応用分野、電子機器の適切な動作における基板ICの役割、およびその製造プロセスを把握する必要があります。
ICキャリア基板
ICキャリア基板は、ベア(未封止)集積回路チップのパッケージングに使用される一種のベースボードです。プリント基板とチップを接続する際に、基板ICは重要です。半導体集積回路チップを一時的に保持する下地として、集積回路はチップをプリント基板に接続する配線を提供します。熱放散経路を与えるだけでなく、ICチップを強化、支持、保護します。
プリント基板のコネクタから半導体チップへの主要な役割は、集積回路基板によって果たされます。高い相互接続密度を提供するために、それはICメーカーにとって限界を必要とし、したがって、チャネルとして機能します。ICキャリア基板の製造プロセスにおいて、これはプリント基板メーカーのそれを上回ります。化学的専門知識において、メーカーは高密度設計と実証された専門性に関する解決策を必要とします。集積回路基板は様々な分類に属し、多様です。
半導体デバイスを含む材料は、ICパッケージングと呼ばれます。電気的範囲の実装を可能にする以外に、ICキャリア基板を囲むパッケージとして、腐食や物理的損傷からそれを保護します。電気的接点をプリント基板に接続する際に、これは特に重要です。様々な集積回路パッケージングシステムの構成タイプが存在します。それぞれが外殻に関して明確な要件を持つため、これらの異なるタイプに対する考慮が不可欠になります。
ICパッケージング
半導体デバイス製造において、これはしばしば最終工程として行われます。集積回路を経年劣化による腐食や外部要因の妨害から保護するため、この段階で半導体はパッケージングされます。電気的接点を促進する以外に、設計によるパッケージングはブロックを保護します。電子デバイスの回路基板に対して、これは信号を伝達します。
EPM(電子機器メーカー)の間で普及するにつれて、ICパッケージング技術は1970年代のBGAパッケージから発展しました。しかし、21世紀初頭には、より新しい選択肢やバリエーションがピングリッドアレイパッケージを凌駕しました。プラスチック四辺リードフラットパッケージや小型薄型外形パッケージがそのような進歩に含まれます。FCBGAのように、現在さらに進んだパッケージング技術が存在します。これは、ランドグリッドアレイパッケージのアップグレード版です。
ICキャリア基板パッケージングの設計
構造に基づいて、ICパッケージング設計も多くの分類を持ちます。それはリードフレームタイプと基板タイプを含みます。これら2つがICパッケージング設計の主要な分類を形成する一方で、他の二次的な分類形態も存在します。以下にそれらを見ることができます。
リードフレームおよびデュアルインレインパッケージ: ピンが穴を通ることを必要とするアセンブリに、このようなパッケージが使用されます。
エリアアレイパッケージ: スペースを監視し、最大の性能を提供する、一種のパッケージです。相互接続のために、チップ表面の残りの領域を利用します。
- ピンマトリックスクラスター:ソケット装着に利用されます。
- クワッドレベルパッケージ:リード外形を持つが、リードレスバンドルタイプです。
- チップスケールバンドル:表面に直接実装可能な単体ダイパッケージです。占有面積が小さい特徴があります。
- マルチチップパッケージ:マルチチップモジュールとも呼ばれます。このパッケージは複数のIC、半導体ダイ、ディスクリート部品をICキャリア基板上に集積します。この構成により、より大規模なICのように見え、マルチチップパッケージを形成します。
- クワッドレベルノーリード:主に表面実装に使用され、チップサイズに近い形状を持つ小型パッケージです。
BGAと同様に、多くの企業がエリアアレイパッケージを採用している点に留意すべきです。これはマルチチップ構造の必要性から生まれています。システムオンチップ設計を採用する構成において、このようなモジュールやパッケージは有力な選択肢を提供します。したがって、最適なICを適切なパッケージとICキャリア基板で入手したい場合は、当社に連絡する前にこれら全てを検討することが有益です。
ただし、当社では一流のカスタマーサービスを提供しています。ご自身の集積回路に最適なパッケージや基板タイプが判断できない場合でも、適切な指導を受けることができます。
ICキャリア基板プリント基板の応用
ICキャリア基板プリント基板は、特定の電子製品に主に適用されます。先進的な機能を備えたこのような製品は、薄型軽量である必要があります。そのため、タブレットコンピュータ、携帯電話、ネットワーク機器、PCをはじめ、軍事、通信、医療、産業制御、航空宇宙分野などでICキャリア基板プリント基板を見つけることができます。また、マイクロLEDもICキャリア基板の応用例の一つですが、多くの場合ミニLEDプリント基板として見られます。
従来のHDIプリント基板、集積回路基板プリント基板、基板様プリント基板、多層プリント基板に至るまで、ほとんどのリジッドプリント基板は様々な技術革新を経て進化してきました。
ICキャリア基板の特徴
集積回路の機能に合わせて、ICキャリア基板は特定の特性を備える必要があります。電子設計者や技術者は、ICを設計する際に最適なICキャリア基板を選択するため、集積回路の特性を理解する必要があります。以下に主要なIC特性をいくつか挙げます:
高エネルギー効率:消費電力が少なく、低コストで製造可能で、体積が小さいため、集積回路はエネルギー効率に優れています。
- コスト効率:ディスクリート部品と比較すると、全ての集積回路は一般的に低コストで優れた性能を発揮します。
- 小型回路:集積回路は概ね小型化されているため、デバッグ、実装、設計プロセスはシンプルで統一されている必要があります。
- 低故障率:従来の回路と比較して、集積回路は故障率が低くなっています。
- 高信頼性:長年にわたる多くの改良により信頼性が向上しており、集積回路は特に一貫性と性能において非常に高い信頼性を備えています。集積回路では、はんだ接合部が大幅に削減されています。仮想はんだ付けの必要性も低減されるため、ICの信頼性がさらに高まります。
これらは集積回路の最も重要な利点の一部であり、その特性も相乗効果を発揮します。しかし、ここで必要なのはそれだけではありません。特に電子製品のICを設計する際には、ICキャリア基板の属性についても考慮を払うべきです。
ICキャリア基板の属性
- IC基板には様々な異なる要素があります。以下の特徴を含みます。
- 溶接接合部とリード線が少ない
- 重量に関しては軽量
- 重量、堅牢性、信頼性などの様々な特性が一定である場合、性能向上が図られます
- 非常に信頼性が高い
- 小型サイズ
- 1高密度相互接続 プリント基板2025年市場展望:未来 展望・成長分析・イノベーション
- 2プリント基板(PCB)のUL 94V-0難燃性規格の理解
- 3Ultraとは高密度相互接続 プリント基板?
- 4トップ10ICキャリア基板製造業者 (2024)
- 5ダイナミック フレックシング VS 静的な静曲げフレキシブル基板デザイン
- 6HDIのクロスストークとインピデンスの不連続性を減らすプリント基板設計
- 7HDIのスタックアップ戦略プリント基板設計
- 8高密度相互接続 プリント基板メーカー 総合ガイド 2025
- 9HDIプリント基板設計総合ガイド:2025年の高密度相互接続技術のマスタリング
- 10プリント基板完成ガイド (2024)

- Skype ID: shawnwang2006
- 電話: +86-755-23724206
- メール: sales@efpcb.com
- クイックコンタクト
